改善短溝道效應(yīng)的方法分享-KIA MOS管
信息來源:本站 日期:2026-01-13
當(dāng)金屬氧化物半導(dǎo)體場效應(yīng)晶體管(MOSFET)的溝道長度(L)縮減至與耗盡區(qū)寬度相近時,器件的電學(xué)特性,諸如閾值電壓VT、亞閾值擺幅SS以及漏電流leakage current等,會顯著偏離長溝道時的行為。
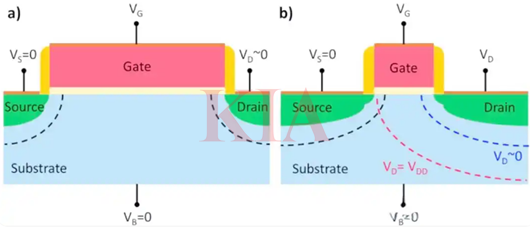
如圖所示,在MOSFET中,由源極和漏極擴散區(qū)域所形成的耗盡區(qū),會向摻雜濃度較低的結(jié)處,即襯底方向延伸。對于長溝道晶體管,其耗盡區(qū)的延伸與柵極總長度相比可忽略不計,因此對晶體管電學(xué)特性的影響也極小。
然而,隨著柵極長度的縮減,耗盡區(qū)的延伸長度與溝道長度相當(dāng),導(dǎo)致柵極對溝道的控制能力部分喪失。這一變化進(jìn)而引發(fā)了短溝道效應(yīng)中的“閾值電壓滾降(VTH roll-off)”現(xiàn)象。

漏致勢壘降低效應(yīng)
此外,當(dāng)在漏極施加偏壓(通常源極接地)時,漏極擴散區(qū)域的耗盡區(qū)會在溝道內(nèi)進(jìn)一步加深,這會導(dǎo)致有效柵極長度減小,即溝道長度調(diào)制效應(yīng)。因此,在VDS等于VGS減去閾值電壓以上時,電流不會達(dá)到飽和狀態(tài)。隨著VDS值的進(jìn)一步增大,漏極耗盡區(qū)會向襯底方向進(jìn)一步延伸,直至與源極耗盡區(qū)發(fā)生重疊。
這一系列變化在短溝道晶體管中會導(dǎo)致柵極對溝道的控制能力進(jìn)一步削弱。由于強漏極偏壓引發(fā)的源極/漏極耗盡區(qū)重疊,會使Source與Bulk結(jié)處的勢壘降低,從而引發(fā)閾值電壓的降低,這種閾值電壓的降低現(xiàn)象被稱為漏致勢壘降低(DIBL)效應(yīng)。
閾值電壓降低與漏電流增加
Vth降低的原因:隨著溝道長度的減小,柵極電場對溝道的控制能力逐漸減弱,而漏極電場對溝道電勢分布的影響則逐漸增強。
Vth降低的影響:可能導(dǎo)致器件在關(guān)態(tài)時的漏電流增加,進(jìn)而影響電路的靜態(tài)功耗和噪聲容限。
漏電流增加的原因:Vth的降低會導(dǎo)致亞閾值區(qū)域的漏電流顯著上升,同時,源漏電阻的降低也會進(jìn)一步加劇漏電流的問題。
漏電流增加的影響:直接導(dǎo)致靜態(tài)功耗的上升,從而影響移動設(shè)備的電池壽命。
驅(qū)動電流的變化
在溝道長度減小的初期,驅(qū)動電流會因溝道電阻的降低而有所增加。然而,隨著溝道長度的進(jìn)一步減小,遷移率的下降和漏電流的增加可能會抵消這種驅(qū)動電流的增加,甚至導(dǎo)致驅(qū)動電流的下降。驅(qū)動電流的變化將直接影響器件的開關(guān)速度和整體電路的性能。
優(yōu)化摻雜工藝
調(diào)整溝道區(qū)摻雜濃度和分布:通過精確控制溝道區(qū)的摻雜濃度和分布,可以有效調(diào)節(jié)晶體管的電學(xué)特性,從而減小短溝道效應(yīng)的影響。例如,采用漸變摻雜技術(shù)可以使得溝道區(qū)的摻雜濃度從源極到漏極逐漸變化,有助于抑制漏電流的增大。
使用高-k介質(zhì)和低功函數(shù)金屬柵極:高-k介質(zhì)可以提高柵氧化層的電容密度,而低功函數(shù)金屬柵極可以降低柵極的開啟電壓,從而在一定程度上補償由于溝道長度縮短而導(dǎo)致的閾值電壓下降。
改進(jìn)晶體管結(jié)構(gòu)
三維晶體管(如FinFET):通過引入三維結(jié)構(gòu),可以增加晶體管的導(dǎo)電通道面積,從而在保持較小溝道長度的同時提高器件的性能。FinFET等三維晶體管結(jié)構(gòu)能夠有效抑制短溝道效應(yīng),提高電路的集成度和穩(wěn)定性。
多柵極晶體管:通過在晶體管中引入多個柵極來控制溝道中的電荷分布,可以進(jìn)一步減小短溝道效應(yīng)的影響。這種結(jié)構(gòu)能夠更精確地調(diào)控溝道中的電場分布,從而提高晶體管的開關(guān)速度和穩(wěn)定性。
應(yīng)用先進(jìn)的制造工藝
原子層沉積(ALD):利用ALD技術(shù)可以精確控制薄膜的厚度和均勻性,從而制備出高質(zhì)量的柵氧化層和界面層。這有助于減小柵極泄漏電流和界面態(tài)密度,進(jìn)而改善短溝道效應(yīng)。
電子束光刻(EBL):EBL技術(shù)可以實現(xiàn)高精度的圖案轉(zhuǎn)移,用于制造具有更小尺寸的晶體管。通過減小晶體管的物理尺寸,可以在一定程度上緩解短溝道效應(yīng)帶來的問題。但需要注意的是,過小的尺寸也可能導(dǎo)致其他新的問題出現(xiàn),因此需要綜合考慮各種因素進(jìn)行優(yōu)化設(shè)計。
聯(lián)系方式:鄒先生
座機:0755-83888366-8022
手機:18123972950(微信同號)
QQ:2880195519
聯(lián)系地址:深圳市龍華區(qū)英泰科匯廣場2棟1902
搜索微信公眾號:“KIA半導(dǎo)體”或掃碼關(guān)注官方微信公眾號
關(guān)注官方微信公眾號:提供 MOS管 技術(shù)支持
免責(zé)聲明:網(wǎng)站部分圖文來源其它出處,如有侵權(quán)請聯(lián)系刪除。
